Kính hiển vi điện tử quét SEM với Mảng lưới bóng (Ball Grid Array)
 Mảng lưới bóng (Ball grid array - BGA) là một công nghệ đóng gói lắp ráp bề mặt gồm có một dãy các bi hàn ở mặt dưới của bó chip. BGA được phát triển để đáp ứng xu hướng trong ngành công nghiệp bán dẫn theo hướng thu nhỏ các mạch tích hợp (IC) cho mật độ cao hơn, tích hợp tốt hơn và cải thiện nhiều chức năng.
Mảng lưới bóng (Ball grid array - BGA) là một công nghệ đóng gói lắp ráp bề mặt gồm có một dãy các bi hàn ở mặt dưới của bó chip. BGA được phát triển để đáp ứng xu hướng trong ngành công nghiệp bán dẫn theo hướng thu nhỏ các mạch tích hợp (IC) cho mật độ cao hơn, tích hợp tốt hơn và cải thiện nhiều chức năng.
Bảng mạch in (Printed Circuit Board - PCB) có mật độ và hiệu suất sử dụng cao hơn nhờ vào mạng lưới bi hàn (BGA). Điều này là do toàn bộ mặt dưới của bó chip có thể được sử dụng để kết nối thay vì liên kết dây dẫn hoặc quad flat pack (QFP) nơi các kết nối chỉ được thực hiện xung quanh đường biên của chip.
Ngoài ra, các bóng hàn cho kết nối ngắn hơn giúp giảm độ tự cảm của tín hiệu, điện áp ít bị nhiễu hơn và cải thiện hiệu suất hoạt động tốt hơn. Để BGA được hàn đúng cách, cần phải sử dụng một lượng nhiệt chính xác để mỗi bóng hàn trong lưới được nóng chảy thích hợp và cho kết nối có chất lượng tốt. Mục đích của việc kiểm tra BGA là để phát hiện và tách biệt các lỗi có nguồn gốc trong quá trình sản xuất như lỗ rỗng hoặc bóng hàn kém và những nguyên nhân gây ra chúng.
- Hệ thống Kính hiển vi điện tử quét SEM và FIB-SEM TESCAN cung cấp nhiều khả năng cho việc kiểm tra và phân tích lỗi của Mảng lưới bóng (BGA).
- Đầu dò EBIC của TESCAN có thể được sử dụng để kiểm tra dòng điện. Có nhiều thử nghiệm khắt khe yêu cầu cần phải phân tích những bi hàn này.
- Đầu dò BSE của TESCAN cung cấp độ tương phản cao cho quan sát rõ ràng các hợp chất liên kim loại và các lớp dưới vết lồi. Việc kiểm tra và xác định đặc tính của mỗi nối bóng hàn trong BGA là nhiệm vụ quan trọng để xác định độ tin cậy của mạch gắn với PCB và cũng rất quan trọng trong việc xác định chất lượng của quá trình hàn và xác định nguyên nhân của các lỗi sai.
- Hệ thống FIB-SEM Plasma của TESCAN cho phép thực hiện cắt ngang các viên bi hàn có đường kính lên đến hàng trăm micro một cách dễ dàng chỉ trong thời gian ngắn.
- Ngoài ra, phép vi phân tích 3D (3D EDX, 3D EBDS) của toàn bộ các mối hàn, cho thấy các lỗ hổng, các vết gãy, vết nứt hoặc cấu trúc dạng cây được thực hiện với tốc độ phún cao mà chỉ FIB Plasma Xe mới có thể làm được.
Một vài ảnh chụp bằng Kính hiển vi điện tử quét SEM & FIB-SEM TESCAN

A cross section of a solder ball milled from the board side (chụp bằng Kính hiển vi điện tử quét SEM & FIB-SEM TESCAN)

A cross section of a solder ball milled from the board side (chụp bằng Kính hiển vi điện tử quét SEM & FIB-SEM TESCAN)

A detailed image showing grain contrast in the pad metal and under bump metallurgy layers (chụp bằng Kính hiển vi điện tử quét SEM & FIB-SEM TESCAN)

BSE image of a cross section of a solder ball showing intermetallic compounds between the solder and metal pad polyimide passivation and underlying IC layers (chụp bằng Kính hiển vi điện tử quét SEM & FIB-SEM TESCAN)
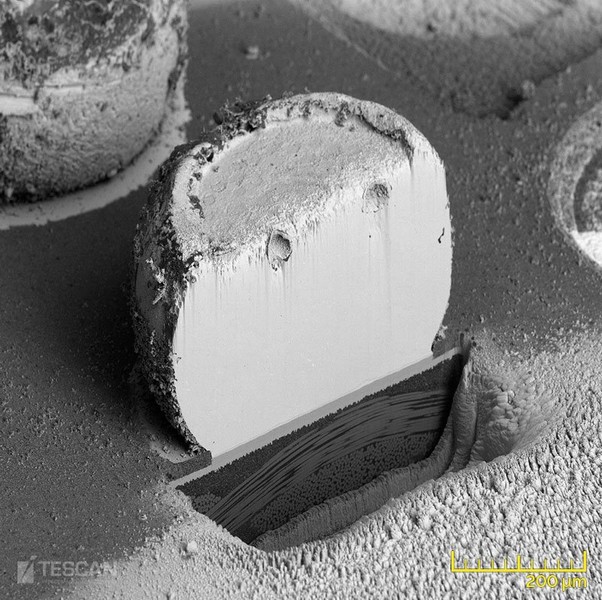
Cross section of a solder ball with a diameter of 400 μm completed in 4 hours using Xe Plasma FIB and Rocking Stage for a curtaining free surface (chụp bằng Kính hiển vi điện tử quét SEM & FIB-SEM TESCAN)

Detailed image of a structure under the solder ball (chụp bằng Kính hiển vi điện tử quét SEM & FIB-SEM TESCAN)

Overview of a solder ball array (chụp bằng Kính hiển vi điện tử quét SEM & FIB-SEM TESCAN)


 Tiếng Việt
Tiếng Việt  日本語 (Japan)
日本語 (Japan)  한국어 (Korean)
한국어 (Korean)  中文 (Chinese)
中文 (Chinese)  English (UK)
English (UK) 